홈으로 돌아가기
Micro Via Hole
고밀도 상호 연결 솔루션
첨단 UV 레이저 Micro Via Hole 공정은 마이크론 수준의 정밀도로 블라인드 비아, 스킵 비아 및 관통 홀 생성을 가능하게 합니다. 당사의 기술은 완벽한 정렬 및 깊이 제어로 깨끗하고 잔여물 없는 비아를 제공하여 고밀도 PCB 설계를 지원합니다.
핵심 역량
비전 기반 정밀 얼라인 (Vision-Driven Alignment)
4포인트 비전 인식을 통해 기판의 신축과 뒤틀림을 정밀하게 보정(Scaling)합니다. 허용 오차를 벗어난 정렬을 사전 감지하여 가공 정합성을 완벽히 유지합니다.
고밀도 인터커넥트 (High-Density Interconnects)
UDD, Skip Via, Through Hole을 단일 공정으로 처리합니다. 복잡한 HDI 구조에서도 설계 및 라우팅의 자유도를 극대화합니다.
도금 최적화 품질 (Plating-Ready Quality)
스미어(Smear) 없는 깨끗한 비아 바닥면을 형성합니다. 후속 도금 공정의 밀착력을 극대화하여 전기적 신뢰성을 보장합니다.

적용 분야 및 변형
전체 역량과 실제 적용 사례를 확인하십시오


적용 사례 1
UDD
FPCB 층간 접속을 위한 핵심 공정입니다. 동박과 절연체를 연속적으로 정밀 가공(Direct Drilling)하여 별도의 CO2 공정을 생략합니다. 잔사 없는 깨끗한 동박 표면을 형성합니다.

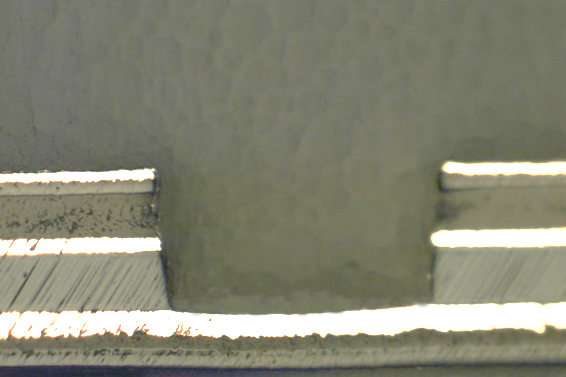
적용 사례 2
Skip Via (멀티 레이어 연결)
상위 구리층과 유전체를 추가로 관통해 목표 레이어까지 한 번에 도달하는 멀티 레이어 비아 기술입니다. 불필요한 층간 이동 없이 신호를 직접 전달하여, 라우팅 혼잡을 줄이고 스택드 비아(Stacked Via) 수를 최소화해 공정 신뢰성을 높입니다.
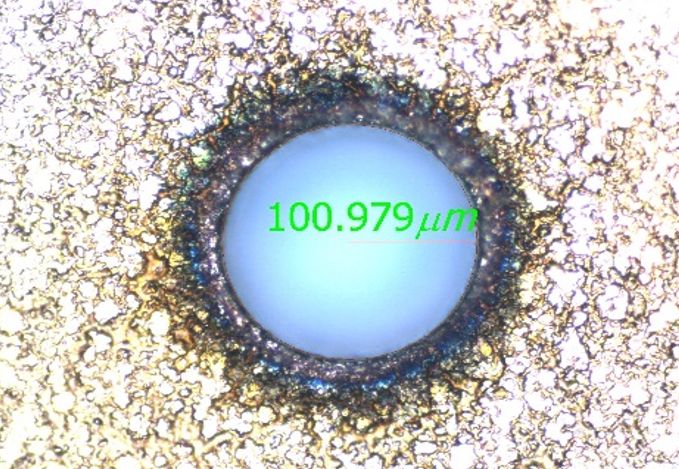
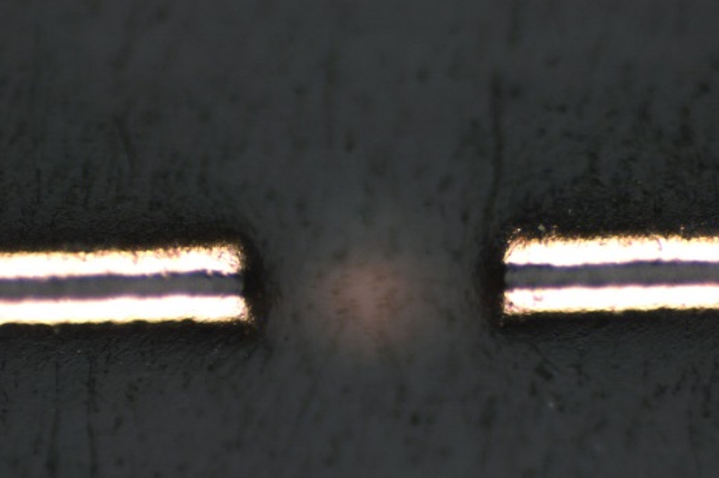
적용 사례 3
Through Hole (Full Through Drilling)
기판의 상·하단 레이어를 완전히 관통하여 연결하는 가장 표준적인 비아 방식입니다. 적층 전 코어 가공 및 양면 기판의 층간 접속에 광범위하게 사용됩니다.